Главная — Каталог — Источники питания для магнетронного распыления импульсами высокой мощности
Источники питания для магнетронного распыления импульсами высокой мощности
Магнетронное распыление импульсами высокой мощности или сильноточное импульсное магнетронное распыление (на анг. high power impulse magnetron sputtering – HIPIMS, или high power pulse magnetron sputtering - HPPMS) представляет собой новый метод физического осаждения из паровой фазы с высокой степенью ионизации распыленного материала (i-PVD), основанный на классическом магнетронном распылении.
Характерной чертой HIPIMS является короткая длительность импульсов (10 – 250 мкс) при относительно невысокой частоте формирования (10 Гц – 10 кГц). Отношение периода к длительности импульсов, как правило, составляет 10 и более. Средняя мощность HIPIMS разряда такая же, как в классических режимах магнетронном распылении (DC – режим постоянного тока; MF – импульсный среднечастотный режим), но поскольку разрядные импульсы имеют относительно короткую длительность, плотность мощности на мишени магнетрона может достигать чрезвычайно высоких мгновенных значений – более 1000 Вт/см2 [1-4].

Благодаря высокой импульсной плотности мощности на поверхности катода обеспечивается высокая концентрация плазмы (до 1013 см-3) и степень ионизации распыленного вещества (до 90%) [5-7]. Ионизованные атомы материала воздействуют на растущее покрытие, улучшая его свойства: плотность, твердость, шероховатость, коэффициент преломления и т.д. [8-11]. Можно утверждать, что HIPIMS является универсальным методом, объединяющим в себе преимущества дугового испарения и классического магнетронного распыления – возможность формирования высококонцентрированных ионно-плазменных потоков без наличия микрокапель.
Режим сильноточного импульсного магнетронного распыления может быть реализован на обычной магнетронной распылительной системе, предназначенной для работы в классических режимах (DC, MF). Ключевую роль здесь играет именно источник электропитания, обеспечивающий заданные параметры импульсов.
HIPIMS метод был разработан в конце 1990-х годов [1]. С тех пор эта технология активно развивается в различных научно-исследовательских группах [12-15]. Постоянно открываются все новые возможности HIPIMS, проявляющиеся в решение конкретных технологических задач, таких как, подавление гистерезисных эффектов в процессах реактивного распыления, получение сверхтвердых алмазоподобных покрытий [16], обработка подложек сложной формы, формирование ультратонких пленок и т.д.. Однако, несмотря на высокие перспективы, широкого внедрения HIPIMS в промышленности пока еще не произошло. Можно констатировать, что данная технология на данный момент не достигла требуемого уровня развития и обладает некоторыми недостатками. Рассмотрим наиболее значимые из них.
Один из недостатков HIPIMS заключается в снижении скорости осаждения покрытий, относительно классических режимов магнетронного распыления. Уменьшение скорости обусловлено эффектом «возвращения» ионизированных атомов обратно на мишень под действием электрического поля [17-19]. Решение данной проблемы зачастую заключается в поиске компромисса между качеством покрытия и скоростью напыления. Также существуют работы, в которых показано, что для некоторых материалов данный недостаток может быть устранен путем оптимизации частоты и длительности импульсов [20-23] или изменения напряженности магнитного поля [24]. Кроме того, снижение скорости можно предотвратить путем применения комбинированных систем электропитания HIPIMS+MF, совмещающих сильноточное импульсное магнетронное распыление с обычным распылением на постоянном токе или импульсным среднечастотным.
Пожалуй, самой большой преградой на пути развития технологий сильноточного импульсного магнетронного распыления и их широкого распространения является отсутствие на рынке (в особенности отечественном) доступных и надежных HIPIMS источников электропитания, к тому же обладающих достаточной управляемостью и гибкостью для удовлетворения разнообразных запросов разработчиков технологий. Нашей командой предпринята попытка исправить сложившуюся ситуацию - разработать новую серию HIPIMS импульсных источников питания, которая обладает более широкими возможностями, относительно предшествующего поколения. Можно перечислить основные особенности источников питания новой серии APEL-HPP:
- способны работать не только в режиме HIPIMS, но и в традиционных режимах: DC и MF (на чатоте до 15 кГц);
- благодаря модульной конструкции перекрывают широкий диапазон средней выходной мощности от 1500 Вт до 100 кВт, выходного напряжения – от 300 до 2000 кВ, и импульсного тока – от 150 до 4000 А;
- обладают широким набором регулируемых временных параметров импульсов (частота, длительность, задержка включения, частота и длительность «пакетов» и т.д.);
- обеспечивают режимы стабилизации импульсного напряжения, среднего разрядного тока, средней мощности разряда;
- позволяют на своей основе реализовывать гибридные системы электропитания, обеспечивающие комбинированное питание магнетронных распылительных систем, а также подачу потенциала смещения на подложку.
В новой серии источников питания можно выделить следующие основные разновидности:
- HIPIMS – униполярные импульсные источники питания для сильноточного магнетронного распыления;
- HIPIMS BP – источники питания, формирующие биполярные ассиметричные импульсы (положительные импульсы тока имеют небольшой амплитуды и предназначены для компенсирования зарядов в процессах реактивного магнетронного распыления);
- HIPIMS+MF(DC) – комбинированная система электропитания, совмещающая сильноточное импульсное магнетронное распыление с обычным распылением на постоянном токе или импульсным среднечастотным;
- HIPIMS+SB – комбинация импульсного сильноточного магнетронного распыления с подачей потенциала смещения на подложку;
- HIPIMS DU – источники питания для дуального сильноточного магнетронного распыления;
- MPPMS – серия источников питания, обеспечивающих модулированное магнетронное распыление импульсами высокой мощности;
- Также возможна реализация комбинированных систем: HIPIMS+MF+bias, HIPIMS DU+SB, HIPIMS DU+MF+SB.
Список используемой литературы:
- Kouznetsov, V.; Macák, K.; Schneider, J. M.; Helmersson, U.; Petrov, I. Surf. Coat. Technol. 1999, 122, 290.
- D.V. Mozgrin, I.K. Fetisov, G.V. Khodachenko, Plasma Phys. Rep. 21 (1995) 400.
- S.P. Bugaev, N.N. Koval, N.S. Sochugov, A.N. Zakharov, Proceedings of the XVIIth International Symposium on Discharges and Electrical Insulation in Vacuum, July 21–26, 1996 Berkeley, CA, USA, 1996, p. 1074.
- K. Macák, V. Kouznetsov, J. Schneider, U. Helmersson, I. Petrov, J. Vac. Sci. Technol., A, Vac. Surf. Films 18 (2000) 1533.
- S.P. Bugaev, N.N. Koval, N.S. Sochugov, A.N. Zarharov. Investigation of a high-current pulsed magnetron discharge initiated in the low-pressure diffuse arc plasma // Proc. XVII Intern. Symp. on Discharges and Electrical Insulation in Vacuum. - Berkeley, USA, 1996. - P. 1074-1076.
- Oks E., Anders A. Evolution of the plasma composition of a high power impulse magnetron sputtering system studied with a time-of-flight spectrometer // Journal of Applied Physics. 2009. Т. 105. № 9. С. 093304.
- Odivanova A.N., Sochugov N.S., Oskomov K.V., Podkovyrov V.G. Study of the plasma parameters in a high-current pulsed magnetron sputtering system // Plasma Physics Reports. 2011. Т. 37. № 3. С. 239-243.
- Bandorf, R.; Vergöhl, M.; Giesel, P.; Wallendorf, T.; Mark, G. 50th SVC Annual TechCon Proceedings; 2007, 160.
- DeKoeven, B. M.; Ward, P. R.; Weiss, R. E.; Scholl, R. A.; Sproul, W. D.; Tomasel, F.; Anders, A. 46th SVC Annual TechCon Proceedings; 2003, 158.
- Helmersson, U.; Alami, J.; Eklund, P.; Andersson, J. M.; Lattemann, M.; Wallin, E.; Bohlmark, J.; Persson, P. Thin Solid Films 2007, 515, 3434.
- Wallendorf, T.; Vergöhl, M.; Werner, O.; Bandorf, R. 51st SVC Annual TechCon Proc.; 2008, 3.
- Christie, D. J.; Tomasel, F.; Sproul, W. D.; Carter, D. C. J. Vac. Sci. Technol. A 2004, 22 (4), 1415.
- DeKoeven, B. M.; Ward, P. R.; Weiss, R. E.; Scholl, R. A.; Sproul, W. D.; Tomasel, F.; Anders, A. 46th SVC Annual TechCon Proceedings; 2003, 158.
- Ehiasarian, A. P.; Münz, W.-D.; Hultmann, L.; Helmesson, U.; Petrov, I. Surf. Coat. Technol. 2003, 163–164, 267.
- Sarakinos, K.; Alami, J.; Konstantinidis, S. Surf. Coat. Technol. 2010, 204, 1661.
- Lin J, Sproul WD, Wei R, Chistyakov R. Diamond like carbon films deposited by HiPIMS using oscillatory voltage pulses. Surf Coatings Technol. 2014;258:1212-1222. doi:10.1016/j.surfcoat.2014.06.061.
- D.J. Christie, J. Vac. Sci. Technol. A 23 (2) (2005) 330.
- W.D. Sproul, D.J. Christie, D.C. Carter, Proceedings of the 47th Annual SVC Technical Conference, Dallas, Texas, April 25-29, 2004, 2004, p. 96.
- D.J. Christie, J. Vac. Sci. Technol. A 23 (2) (2005) 330.
- R. Chistyakov, B. Abraham, and W.D. Sproul, Proceedings of the 49th Annual SVC Technical Conference (Washington, DC, April 23–27, 2006), pp. 88–91.
- R. Chistyakov, B. Abraham, W. Sproul, J. Moore, and J. Lin, Proceedings of the 50th Annual SVC Technical Conference (Louisville, KY, April 30–May 3, 2007), pp. 139–143.
- W.D. Sproul, D.J. Christie, and D.C. Carter, Proceedings of the 47th Annual SVC Technical Conference (Dallas, Texas, April 25–29, 2004), pp. 96–100.
- W.D. Sproul, R. Chistyakov, and B. Abraham, Society of Vacuum Coaters News Bulletin (Summer 2006), pp. 35–37.
- Raman P, Shchelkanov IA, McLain J, Ruzic DN. High power pulsed magnetron sputtering: A method to increase deposition rate. J Vac Sci Technol A Vacuum, Surfaces, Film. 2015;33(3):031304. doi:10.1116/1.4916108.

Источники питания для биполярного сильноточного импульсного магнетронного распыления
Серия: APEL-HIPIMS BP
High-power bipolar impulse magnetron sputtering
0 руб.
Заказать
Гибридные системы электропитания для импульсного магнетронного распыления
Серия: HIPIMS hybrid
Hubrid high-power impulse magnetron sputtering
0 руб.
Заказать
Дуальное импульсное сильноточное магнетронное распыление
Серия: HIPIMS DU
High-power impulse dual magnetron sputtering
0 руб.
Заказать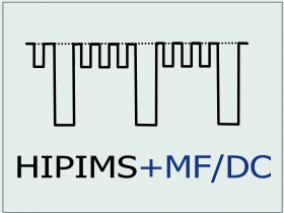
Сильноточное + среднечастотное импульсное магнетронное распыление
Серия: HIPIMS + MF (Medium frequency pulses)
0 руб.
Заказать
Импульсное модулированное магнетронное распыление высокой мощности
Серия: MPPMS (Modulated pulse power magnetron sputtering)
0 руб.
Заказать
